
天眼查显示,深圳中科飞测科技股份有限公司近日取得一项名为“检测设备及其检测的新方法”的专利,可提升基于莫尔条纹的检测的新方法的检测速度,增加检测设备的检测功能。
天眼查显示,深圳中科飞测科技股份有限公司近日取得一项名为“检测设备及其检测的新方法”的专利,授权公告号为CN114688973B,授权公告日为2024年6月4日,申请日为2021年2月2日。

随着半导体行业的发展,半导体器件的关键尺寸逐渐缩小,在半导体制程中,小的生产误差也有一定的可能引起半导体器件的失效,这就对半导体检测系统提出更高的要求。
半导体器件的生产的全部过程包括:在硅基底上一层层沉积多层堆叠的膜层,并在每次膜层中通过刻蚀形成不同的图案。在刻蚀膜层形成图案的过程中,上下两层膜层的图案的位置一定要满足套刻要求。为了监控上下两层膜层之间的相对位置关系,在刻蚀膜层的同时在切割道区的膜层中形成套刻标记。通过对套刻标记进行套刻测量,确定上下层图案的对准误差,从而对半导体制程进行监控。
现有技术中,套刻测量的方法有:基于成像的光学测量方法(IBO),基于衍射的光学测量方法(DBO)以及基于莫尔条纹的测量方法。由于基于莫尔条纹的检测的新方法能够将小空间周期的套刻标记的对准误差转换为大空间周期的莫尔条纹的对准误差,从而可提升检测精度。然而随着半导体器件集成度的提高,套刻标记的尺寸逐渐减小,莫尔条纹的检测的新方法逐渐显示出其优势。
然而,传统的基于莫尔条纹的检测的新方法的检测速度较低,导致半导体生产的吞吐量较低。
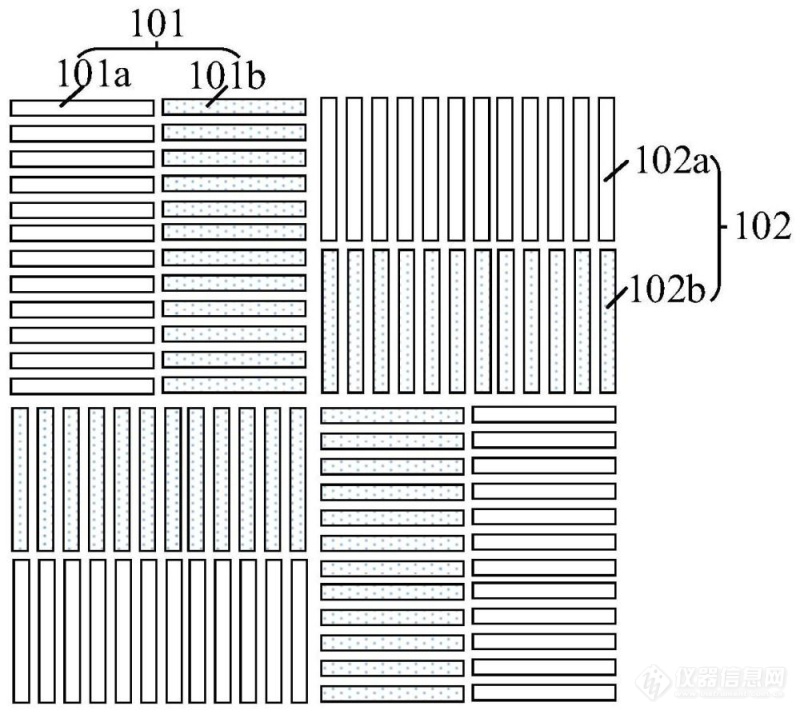
据专利摘要显示,未解决以上问题,本发明提供一种检测设备,其中,所述检测设备包括:发光装置,用于产生照射待测物的入射光,所述入射光用于在所述图案标记表明产生图案光斑,所述待测物表面具有图案标记,所述图案光斑用于与所述图案标记形成莫尔条纹,所述图案光斑包括多个条纹光斑,所述多个条纹光斑的条纹延伸方向不同;成像装置,用于收集所述信号光并根据所述物镜收集的信号光形成检测图像。所述图案光斑包括多个条纹光斑,所述检测设备获取的图案标记的信息较多,进而能够增加检测设备的检测功能,且可提升检测速度。